그로쓰리서치, ‘하이브리드 본딩 산업 분석 보고서’ 발표
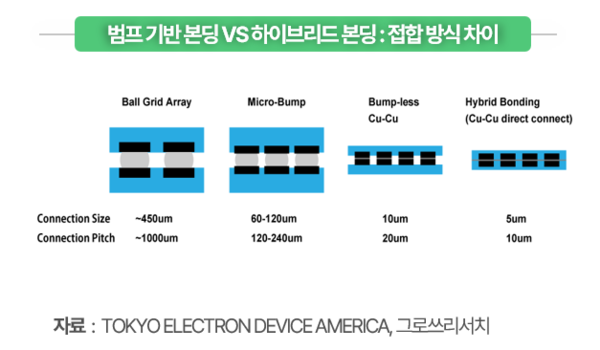
AI(인공지능) 시대를 맞아 하이브리드 본딩 기술이 선택이 아니라 HBM·3D-IC 시대에 기술적으로 강제되는 필수 공정이라는 분석이 나왔다.
24일 스몰캡 전문 독립 리서치 기업 그로쓰리서치(대표 한용희)에 따르면 이날 정기 리포트를 통해 AI 반도체 구조 변화의 핵심 기술로 부상한 ‘하이브리드 본딩(Hybrid Bonding)’ 산업 분석 보고서를 발간하고 조사 결과를 공개했다.
이번 하이브리드 본딩 산업보고서는 글로벌 반도체 업체의 공정 로드맵과 기술자료를 기반으로 약 2주간 데이터 수집과 비교 분석을 진행해 완성됐다. 전공정 중심에서 후공정 중심으로 이동하는 반도체 패키징 패러다임 변화가 본격화됐다고 평가했다.
보고서는 기존 마이크로 범프 방식이 20마이크로미터 이하로 피치를 줄이는 과정에서 쇼트, 열저항 증가, 신호 지연 등 구조적 한계를 보이며 HBM4, 3D-IC 같은 초고집적 구조를 더 이상 지원하기 어렵다고 지적했다. 반면 하이브리드 본딩은 범프를 완전히 제거하고 구리-구리(Cu-Cu)를 직접 접합하는 방식으로 전환해 초미세 피치, 낮은 열저항, 신호 지연의 최소화를 동시에 구현할 수 있어 향후 AI 반도체 성능을 좌우하는 핵심 공정으로 평가된다.

그로쓰리서치는 특히 “하이브리드 본딩은 선택이 아니라 HBM·3D-IC 시대에 기술적으로 강제되는 필수 공정”이라며 “전공정에서 사용하던 정밀 공정들이 후공정으로 확장되는 구조적 전환의 시작점”이라고 진단했다.
이번 보고서는 CMP(평탄화), 세정·활성화, 정렬·본딩, 어닐링, 검사·계측 등 다단계의 고난도 기술로 구성되어 있으며, 각 단계별로 국내 반도체 장비·소재 기업들이 구조적으로 수혜받을 가능성이 있다고 분석했다.
대표적인 기업으로는 CMP 장비 분야의 케이씨텍, 하이브리드 본더 개발을 추진 중인 한미반도체, 원자힘현미경(AFM) 기반의 초정밀 계측 장비를 보유한 파크시스템스, TSV 오버레이 계측을 담당하는 오로스테크놀로지가 언급됐다.
다만 보고서는 이러한 기업들이 대부분 공정이 성숙한 이후 진입하는 ‘세컨드 플레이어’의 성격이 강하다고 평가했다. 하이브리드 본딩 초창기에는 글로벌 메모리 제조사와 직접 공정을 공동 개발할 수 있는 기술력이 필수인데, 현재 국내외를 포함해 이 조건을 충족하는 업체는 매우 제한적이라는 것이다.
반면 HPSP는 보고서가 지목한 국내에서 유일한 초기 선도 기업으로 평가됐다. HBM4(16단) 이상부터는 고온 공정이 불가능해져 저온에서 Cu-Cu 접합을 완성해야 하는데, 이를 구현할 수 있는 기술이 바로 HPSP의 고압 수소 기반 저온 어닐링 기술이다. 이 기술은 구리 표면의 산화막을 제거해 접합력을 높이며, 낮은 온도에서도 완전한 Cu-Cu 결합을 가능하게 만드는 사실상 대체 불가능한 방식이다.
보고서는 “저온 Cu 활성화는 하이브리드 본딩 공정의 핵심이자 대체 기술이 존재하지 않는 영역이며, HPSP는 이 공정에서 독점적 지위를 확보하고 있다”고 설명했다.
그로쓰리서치는 “케이씨텍·한미반도체·파크시스템스·오로스테크놀로지 등은 공정 확산 이후 수혜가 기대되는 후방 장비 기업들이며, 시장 성숙 시점에서 이중 수혜가 가능하다”면서도 “현재 하이브리드 본딩의 초기 공정을 실질적으로 주도할 수 있는 기업은 HPSP가 사실상 유일하며, 기술적·안전적 진입장벽을 고려하면 단기간 내 경쟁사가 등장하기 어렵다”고 평가했다.
한용희 대표는 “하이브리드 본딩은 단순한 패키징의 업그레이드가 아니라 AI 반도체 성능의 방향을 바꾸는 구조적 기술 변화”라며 “이 변화의 초입에 있는 HPSP는 명확한 선도 기업이며, 전공정 기술이 후공정으로 이동하는 가운데 국내 장비·소재 기업 전반에도 중요한 기회가 열리고 있다”고 말했다.







